气体分子污染物(AMC),又名为悬浮分子污染物/气载分子污染物,是危害微电子生产工艺并导致成品率降低的分子态化学物质,大多出现在洁净室和受控环境的大气中。
对于微电子洁净室控制的挑战在于AMC分子污染物的尺寸比粒子要小得多,会在半导体制造的栅底氧化、薄膜沉积、多晶硅和硅化物形成、接触成型、光刻等多个关键工艺上对晶片表面、设备表面产生侵蚀,还会产生非控制性硼化物或磷化物掺杂、晶圆表面或光学镜面产生阴霾、微粒产尘等危害,从而大大影响了产品的质量。
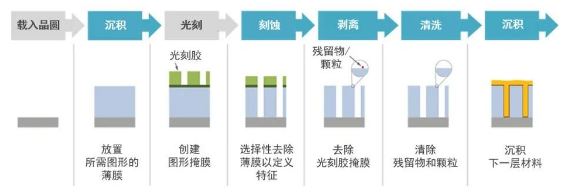
晶圆加工流程 图源:泛林集团

AMC分类标准 图源:AAF(爱美克)
根据化学品的特性,在国际半导体设备及材料协会在SEMIF21-1102的标准中将洁净室中的空气污染物分为四种,一是酸性污染物,包括盐酸、硝酸、硫酸、氢氟酸等,能够诱发硼污染;第二种是碱性污染物,主要是氨气,会造成保护层显影不良;第三种是可凝性污染物,第四种是掺杂性污染物,两者会造成元件表面污染,如P/N翻转、氧化膜老化,金属离子造成结合不紧密等。这些AMC主要来源包括工艺排风、汽车尾气、锅炉排烟以及化工厂排气等;洁净室内AMC的来源包括管路泄漏、清洗和湿法刻蚀设备泄漏、建筑与设备材料气体散发和洁净室内人员携带等。
另一个挑战在于,随着大尺寸晶圆的普及,单个晶圆的成本增加,针对机台控制纳米级颗粒物和AMC污染的需求也相应增加。此外,在EUV机台和多重曝光DUV光刻机中使用的无缺陷掩膜的成本上升,给厂务端的系统控制以及量测机台和掩膜版存储等微环境的污染控制系统带来了压力。
半导体工艺中,HEPA/ULPA过滤器是控制微粒污染的传统技术。大多数洁净室可以通过HEPA/ULPA过滤器控制大粒径的悬浮污染微粒物,但随着半导体产品工艺尺寸由微米级向纳米级的趋势挺进,小颗粒污染物对产品的影响越来越大。而这些悬浮分子污染物又很难通过HEPA/ULPA过滤器进行处理:
· 理论上,HEPA过滤器可以过滤掉99.97%以上0.3 μm以上粒径的颗粒,ULPA过滤器可以过滤掉99.999 %以上120 nm以上粒径的颗粒。AMC以气相或蒸汽分子的形式存在于半导体洁净室中,其粒径通常只有 0.2nm~5nm,能畅通无阻地穿过 HEPA / ULPA过滤器。而且,空气中AMC的浓度比颗粒要高得多。
· 测量结果表明,在 209D标准 100级(相当于 209E标准 M3.5级,或 ISO 14644-1标准 5级)洁净室中,总气态有机污染物浓度约为 100μg/m3,而颗粒污染物的浓度仅为 20 ng / m3,两者相差 5000倍。在洁净度最高的光刻间和刻蚀间中, AMC的浓度往往比其他工艺间更高。
所以,研究测量并控制AMC的浓度含量成为了众多生产商关心的重要问题。
01AMC实时监测系统
实践证明,深紫外光刻工艺深受多种类微量污染物的影响,对很多微量污染物极为敏感,尽管随着深紫外耐腐蚀材料技术的发展,已经减少了长时间持续实时监测,而实际上AMC的实时测量对产品质量的好坏至关重要。
而传统的方法大多使用冲击滤池、离子色谱法、化学荧光法,这些间接测量和分析方法速度太慢,操作过程太复杂,价格昂贵且测量结果不准确。
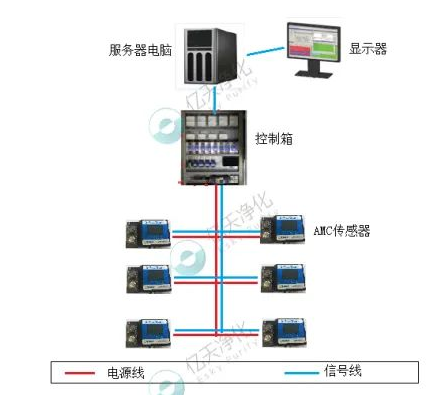

AMC在线监测系统 图源:亿天净化
半导体业者为了与其他竞争者拉出领先差异,对于 AMC 的全面性检测标准要求日益严格。如中芯国际、台积电等知名半导体大厂都已导入AMC在线(实时)监测系统,因为所有业者都了解,透过良率的提升,将是维持竞争优势的最大命脉。
在线(实时)监测系统对于半导体生产过程非常重要。该系统可完全与高科技生产厂房洁净环境管理需求相结合。在包括光刻、蚀刻、扩散、金属化、薄膜、离子注入、量测机台以及光罩或晶圆存储区域和制程中,能够满足快速监视、警报、低浓度测量、宽测量范围以及对多种气体的高度敏感响应等半导体行业的刚性要求。实现对厂房内外的空气质量进行评估,并获取可作后续比对的关键数据,以确认目标污染物和可能对AMC控制系统运行产生影响的物质,进而通过杜绝关键性微污染物的过滤洁净方法而达到良率提升的目的。

FOUP 内的 AMC 和颗粒物监测配套设备 图源:PFEIFFER

光腔衰荡光谱仪 图源:中国科学院长春光机所
光腔衰荡光谱技术是近年来兴起的一种新型光谱检测方法。该技术具有吸收光程长,不受光源强度起伏影响的特点,特别适合物质微弱吸收,而且装置简单、易于定量测量,被应用于镜片反射率的精确测量(精确度高达10-4~10-6)和微量气体检测等方面。
02FFU风机过滤单元
从生产层面上看,微电子产品的制造工序复杂且繁多,其中许多关键工艺需要在恒温、恒湿、超洁净的无尘环境下进行。高效过滤风机组单元(FFU),在集成电路芯片制造领域已逐渐成为最主要的洁净设计方案。主要在微循环风口设置化学过滤器。

自带风机过滤机组 图源:MayAir(美埃)

FFU群控系统 图源:佰伦
FFU循环风系统,是由FFU提供循环空气的动力,整个洁净室的空气通过若干台小风机实现系统内的循环。FFU具有灵活性,可适应工艺变化,当芯片各制程工艺发展需要提高空气洁净度级别时,采取增加FFU数量或更换更高效率的过滤器的方法就可达到提高洁净度等级的目的。
在AMC采样测试与日常控制中,通常采用FFU加载化学气体处理的解决方案,对实际环境中的空气质量数据进行快速准确的提取和整理,并依此制定合理的解决方案。
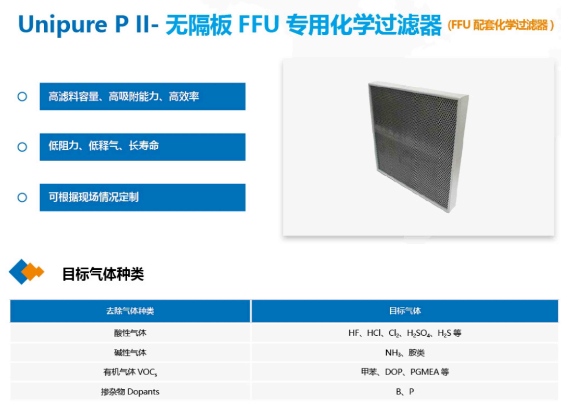
化学过滤器的定义为空气分子污染隔离用的过滤器,其原理是通过物理和化学结构来实现。过滤材料是过滤器的核心部分。化学过滤器的吸附材料有多种,如活性炭、氧化铝、沸石、硅胶、离子交换树脂等。

FFU作为核心元素之一,参与到微电子洁净室立体化系统中

在集成电路芯片制造中,不同的工艺制程对洁净度的要求不尽相同,例如光刻要求在1级的微环境下,而化学机械抛光(CMP)则只要求1000级的环境即可。采用FFU系统的洁净室一般通过FFU的分布率来决定该洁净室的洁净等级,洁净室的正压通过新风量来控制,洁净室温湿度的控制通过循环空气冷却系统(RCU)和新风空调系统(MAU)完成。